越来越多的努力投入到开发隐形
电路及其光电器件中。这个领域被称作透明
电子或者薄膜透明电子器件领域,有望产生许多新产品和新商机。仅举几个例子,比如它可能会引导汽车智能防风罩、智能建筑窗户、透明平板显示器和透明太阳能电池板产品的出现。
在许多透明电子系统中,晶体管都是至关重要的部件。如今,这种器件通常是薄膜晶体管形式,由In2O3、ZnO2、SnO2等透明导电氧化物材料制成。
不过,薄膜晶体管的性能远远低于更常见的可视晶体管,如硅基MOSFET。这归因于透明晶体管材料的固有物理性质差,包括多晶结构、低热导率、低电子迁移率——在In2O3、ZnO2和SnO2中,迁移率通常仅为100 cm2 v-1 s-1,是硅基晶体管的四分之一。低电子迁移率阻滞了透明晶体管的电流承载能力。目前,薄膜晶体管受限于低电流、低速率、且需高压驱动。当务之急是找出能生产透明高性能器件的替代材料。
替代导电氧化物的候选材料包括碳纳米管、石墨烯和二维过渡金属二硫化物。不过,它们皆存在着实际应用中很难克服的缺陷。碳纳米管受限于团聚、分散、纯化和排序的问题;石墨烯妥协于产出优质材料的制造问题,其固有的带隙限定阻碍晶体管通道完全闭合;二维过渡金属二硫化物受损于其比透明导电氧化物还低的载流子迁移率。
在新加坡-麻省理工学院研究与技术联盟,正在先行研发一种有前景的替代材料:GaN。从光学角度看,GaN的带隙为3.42eV,与其他竞争者的带隙相似(In2O3、ZnO2和SnO2带隙分别为3.75 eV、3.35 eV和3.6 eV),鉴于GaN吸收波长为362 nm,能够在整个可见范围内实现透明。从电气性能角度看,GaN完胜。块体GaN电子迁移率是硅的两倍多,而二维电子气形态的GaN电子迁移率则是硅的四倍。正如GaN具有高临界击穿电场和高热导率,GaN也具有远高于硅的载流子饱和速度。
透明晶体管的障碍
典型GaN晶体管的核心是一个导电通道,它由AlGaN阻挡层和GaN缓冲层间界面上产生的二维电子气形成(见图1)。这种器件倾向在一个异质基板上生产,典型的是硅或碳化硅,并具备三个电极:源极、漏极、栅极。为确保透明性,透明有效材料即氮化镓基材料——必须与透明基板和透明电极一起使用。
使用透明基板并不困难。虽然许多氮化镓器件是在不透明基板例如硅上生长氮化物层而形成,但同样有许多透明材料可供选择,包括SiC、蓝宝石、AlN和原生块体氮化镓。不过,所有这些材料价格昂贵,而最常用的透明电路基板——玻璃,则非常便宜。
我们的解决方案是一个两步式制程,可在玻璃基板上形成氮化镓晶体管。第一步是在将氮化镓层转移到玻璃基板之前,将氮化镓材料沉积在便宜但可见的硅基板上。或者,我们可以使用最近由东京大学Hiroshi Fujioka研究
小组研发出的新技术,直接在玻璃基板上溅射氮化镓材料。
电极该如何制作呢?一般地,氮化镓晶体管以镍和金的薄膜组配作为栅极金属,并采用肖特基接触或金属氧化物
半导体(MOS)结构。为确保透明,我们可以调整这种设计,将这些不透明金属改变为透明导电材料如氧化铟锡,它广泛应用于透明电子产品中。这种氧化物是个好选择,因为它能与AlGaN/GaN形成良好的肖特基接触,并在GaN晶体管中起到栅极的作用。有一些报道证实在氮化镓晶体管中可存在铟锡氧化物(ITO)栅极,并且已经表明,在氮化镓器件中以氧化铟锡(ITO)为材料的MOS结构也可以用作GaN器件的透明栅极。
对于源极和漏极,我们必须在源极和漏极材料以及通道材料之间形成欧姆接触。传统的材料选择是金属,例如钛和铝的薄膜组配。仅用ITO来代替这些不透明材料并不可选,因为金属氧化物不能与二维电子气形体形成欧姆接触(见图2)。请注意,尽管提高退火温度可以增加载流,但即使在900°C时,二者也无法形成欧姆接触。
透明欧姆接触
对能带的模拟揭示了为何ITO不能在氮化镓晶体管中形成良好的欧姆接触。模拟结果表明,ITO和在AlGaN和GaN界面的二维电子气之间存在着一个高能势垒(见图3(a))。这个势垒阻碍电子在氧化铟锡和氮化镓三角阱之间平顺移动,从而妨碍二者形成好的欧姆接触。若想实现欧姆接触,则需要一种方法来降低AlGaN/GaN材料导带以贴近ITO,从而使能量势垒最小化(见图3(b))。
利用离子注入掺杂AlGaN和GaN是降低电子导带的一种有效方法。我们在这方面有着丰富的经验,优化了离子注入技术以形成高掺杂的AlGaN/GaN区域,并在GaN晶体管中实现了良好的CMOS兼容欧姆接触。我们的努力包括开发出一种激活退火法,使用氨而不是更常见的氮来减少氮化镓晶体管在高温退火过程中的表面损伤(见图4)。我们通过优化离子能量、剂量、活化退火热预算和金属退火后热预算,实现了注入区在良好欧姆接触和方阻方面都有优良的结果(见表2)。
最近,我们已经将这些硅离子注入技术应用到我们的透明器件上。我们采用的注入条件是30 keV能量,2 x 1015 cm-2剂量,加上80 keV能量,2 x 1015 cm-2剂量,倾斜7°,使用300 nm SiO2层作为硬保护膜。用PECVD来沉积。我们通过在氨气气氛中加热到1200°C 保温5秒来激活硅离子。最后一步是溅射ITO薄膜,然后在氮气气氛中退火。
这种方法可以在ITO和硅注入的AlGaN/GaN异质结构之间形成良好的欧姆接触(见图5)。注意到退火温度仅为400°C时就会形成良好的欧姆接触。回想一下,这与未注入硅的样品在600°C以下退火时没有任何电流形成鲜明对比(见图6)。因此,硅注入毫无疑问对ITO和GaN材料之间形成欧姆接触非常有利。
工作晶体管
为了测试这种方法,我们将透明的源极和漏极欧姆接触技术应用到了真正的氮化镓晶体管上,其设计如图1所示。在这些器件中,二维电子气霍尔密度和迁移率分别约为8x 1012cm-2和1500-1600cm2 v-1s-1。在硅离子注入的辅助下形成ITO欧姆接触,然后在600°C的氮气气氛中退火1分钟。
在我们的器件上进行直流测试,显示结果优良,表明氮化镓在未来透明电子系统中有很大的应用潜力。我们的晶体管栅极—源极距离为1.5μm的,栅极长为2μm,栅极—漏极距离为9.5μm,呈现的最大漏电流为602 mA/mm,最大跨导为121 mS/mm,阈值电压通常为-3.0 V。这些值均与传统金属电极器件相似,可以表明ITO栅极和制造工艺不会在器件表面引入明显的附加电荷。据其他的可靠报道,ITO和AlGaN/GaN之间的肖特基势垒高度为0.7eV,略高于0.62eV。
我们的工作着重强调了透明氮化镓晶体管的潜力。为了促进其发展,我们还将进一步优化透明欧姆接触和降低接触电阻。这可能会引导诞生出具有优良射频或功率性能的完全透明氮化镓晶体管,并最终实现氮化镓透明电路和系统的量产。
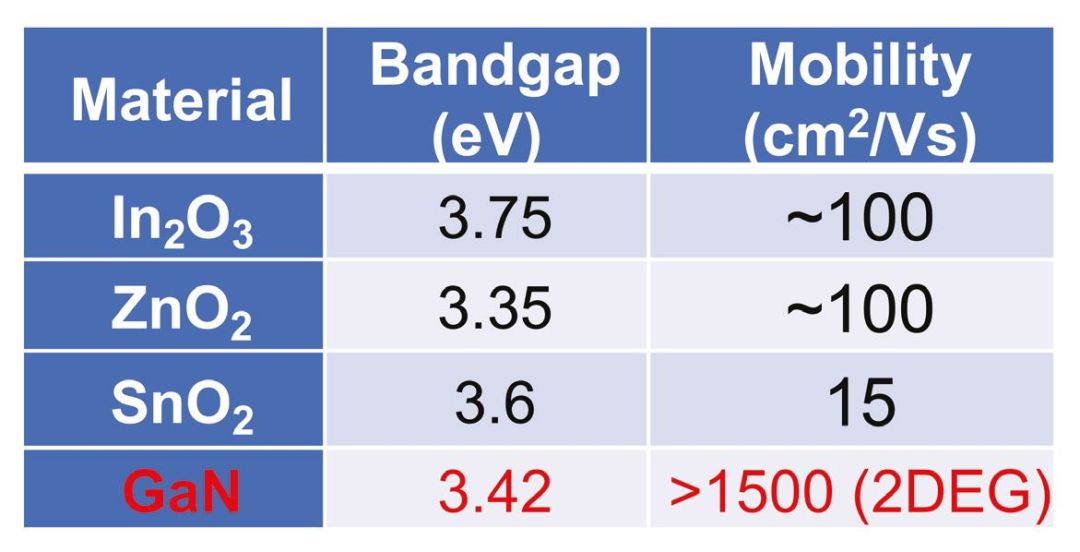
表1. 氮化镓透明导电氧化物和如今透明晶体管中的载流子迁移率比较。
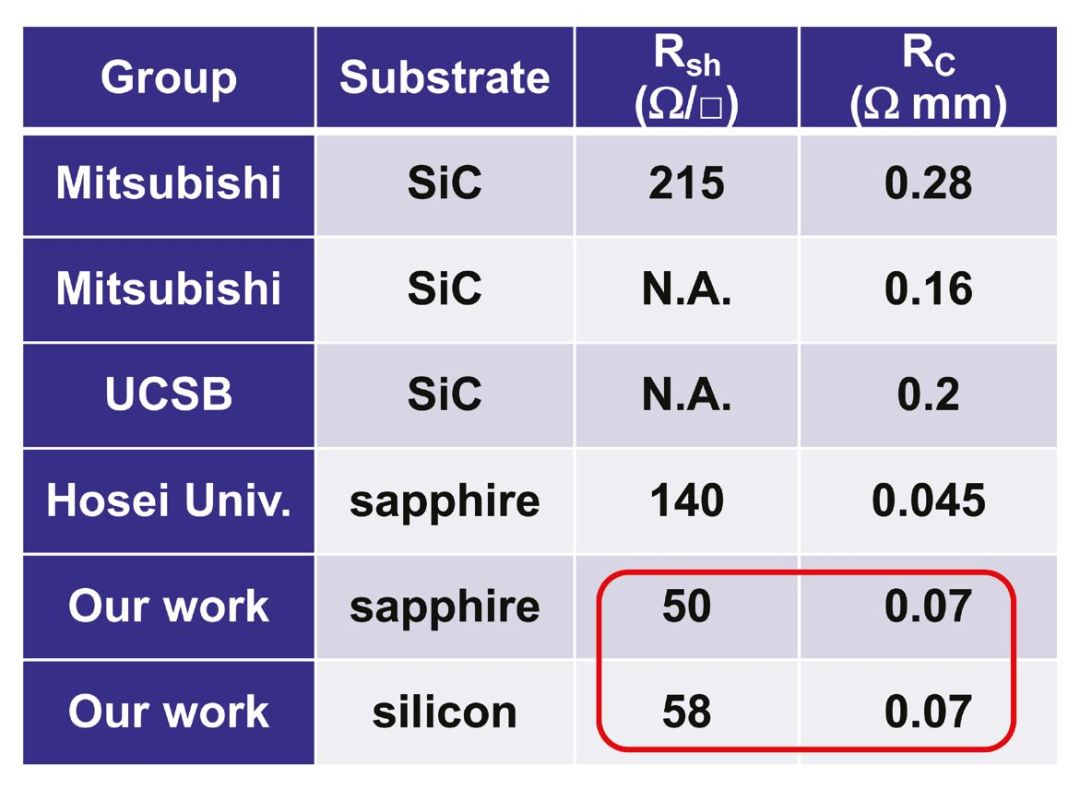
表2. 采用新加坡-麻省理工学院研究与技术联盟开发的硅离子注入和CMOS兼容(
ti/Al金属)欧姆接触技术,在注入区域的方阻(RSH)和欧姆接触(RC)方面都取得了良好的效果。

图1. 传统氮化镓晶体管一定能修改成透明器件。
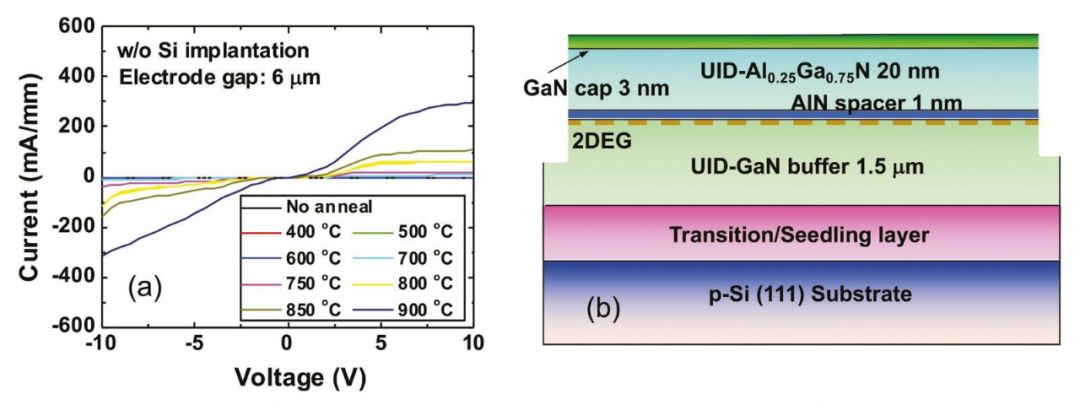
图2.(a)在不同退火温度下,两个ITO电极测得的电流-电压(I-V)曲线。结果表明,当退火温度低于600℃时电流很小,可以忽略不计。将温度升高到700°C会有电流出现,但即使退火温度高达900°C,欧姆接触也无法形成。该晶体管(B)中的氮化物材料由外延片供应商IQE通过将200 mm的 p型硅片装入MOCVD室生长得到。
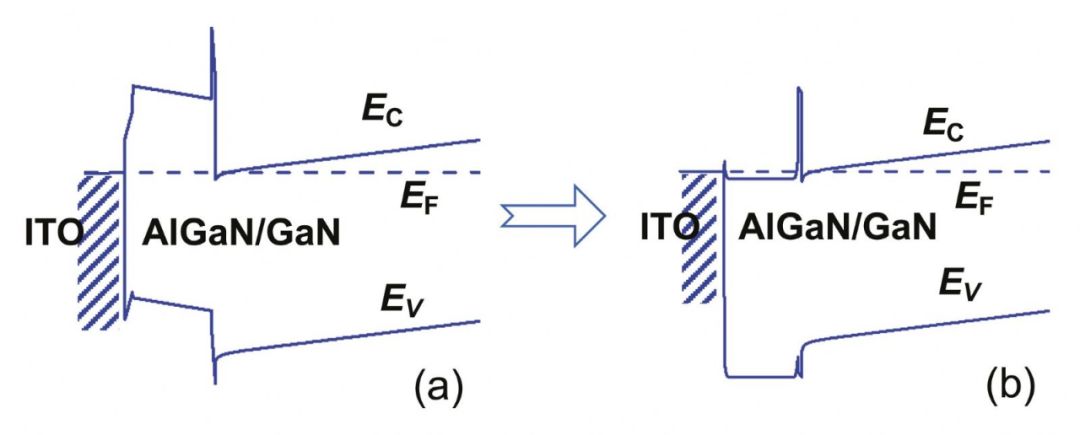
图3. (a)ITO和AlGaN/GaN异质结的能带图,在AlGaN/GaN异质结的界面处,ITO和二维电子气(2DEG)之间存在着较高的能级。(b)为了形成良好的欧姆接触,需要降低靠近ITO的AlGaN/GaN材料的导带,将能量势垒最小化。

图4. 氨活化退火可大大抑制高温(1200°C,2分钟)对表面的损伤。

图5. 在Algan/GaN异质结构中,ITO和硅注入区之间形成了良好的欧姆接触。
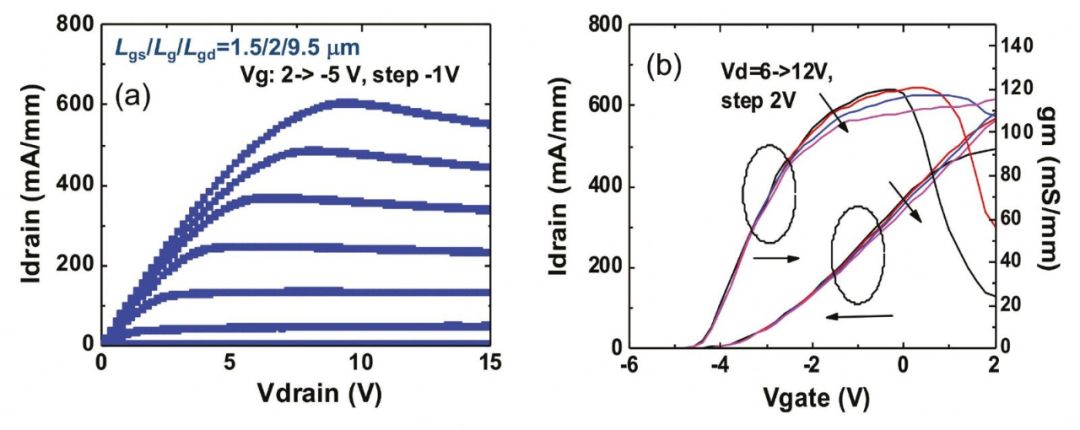
图6. 测得的直流性能,包括(a)带有ITO源/漏(S/D)和栅电极的GaN晶体管的输出(b)特性。


