1. 关于什么是系统级封装(SiP),业界有一致的看法。
实际上是五花八门。SiP的定义差异如此之大,以至于TechSearch Interna
tional近期的SiP报告(1),第一章罗列出了来自一系列SiP供应商和用户超过20多个的SiP定义。为了给报告和预测确定依据,第一章对SIP提供以下定义:
“系统级封装(System-in-Package)是一个集成在标准封装内的功能系统或子系统,例如LGA, FBGA, QFN, 或 FO- WLP。它包含两个或多个不同的芯片,通常与其他组件组合,如无源器件、滤波器、MEMS、传感器和天线。这些组件一起被安装在基板上用于创建定制化,高度集成化的产品,去达到设定的应用。SiPs可以使用先进的封装组合,包括裸芯片(丝焊或倒装芯片)、晶圆级封装、预先封装的集成
电路(如CSPs)、堆叠封装、堆叠芯片,或这些的任意组合。”
此定义认为多芯片封装(MCP)和多芯片模块(MCM)不是SiP,但不同的供应商认为这可以是SiP。这对分析和预测SiP市场增加了挑战。许多MCPs诸如堆叠芯片封装(CSP)之类的器件组合,这种封装产品会将闪存和RAM通过多个芯片堆叠一起,以达到提供更大的存储容量,或者使用MCM或模块,其中的解决方案是自定义装配格式,而不是像细间距球栅阵列(FBGA)那样的标准封装平台。


 举报
举报
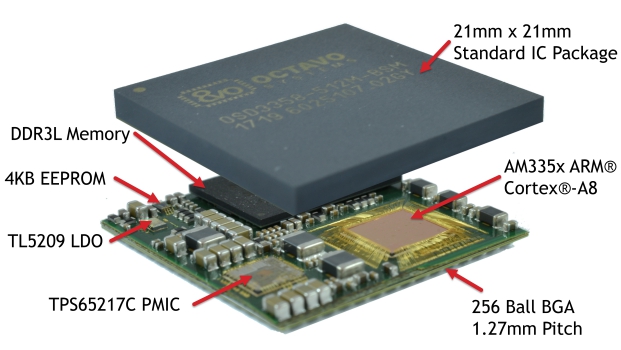

 举报
举报

